
Появление в начале 21 века технологий глубокой (DUV) и экстремальной ультрафиолетовой фотолитографии (EUV) и разработку специальных машин на базе этих технологий можно считать революционным. Это как сравнить с эффектом появления типографского станка Гутенберга в середине 15-го века. Вся электроника, которой мы пользуемся ежедневно, управляется микросхемами с миллиардами транзисторов. Сложный и кропотливый процесс фотолитографии это ключевая основа их производства, позволяющая размещать большое количество интегральных схем на крошечных кремниевых пластинах. Буквально все, от ПК, ноутбуков, планшетов, автомобилей до смарт-часов работает на нескольких видах современных микросхем. CPU, GPU, SoC, DRAM, NAND — эти микросхемы содержат миллиарды крошечных транзисторов, соединенных вместе несколькими слоями дорожек, которые проводят ток. А крупнейшим производителем машин для DUV и EUV-литографии является нидерландская ASML. Поэтому давайте познакомимся поближе с их производством
Содержание
Передовая фотолитография на примере ASML
Мельчайшие элементы в транзисторах имеют размеры около 10 нм, что эквивалентно 45 атомам кремния. Для производства столь сложных микросхем используется ряд последовательных фотолитографических процессов. Каждый из них, в свою очередь, состоит из нескольких этапов, которые выполняет специальная фотолитографическая машина. Это в чем то похоже на работу копировального аппарата. Она переносит на кремниевую пластину крошечные рисунки элементов транзисторов и слоев дорожек, которые их объединяют.
Постоянное совершенствование элементов фотолитографической машины позволяет печатать схемы меньших размеров и размещать на кремниевой пластине большее количество транзисторов. Современные машины фотолитографии работают с экстремально глубоким ультрафиолетовым светом (EUV). Они состоят из фотомаски, которая представляет собой фактически трафарет слоя транзисторов для будущей микросхемы. В машину загружается предварительно обработанная кремниевая пластина диаметром около 300 нм. С помощью ультрафиолетового света и специальных зеркал шаблон переносится на крошечную подложку. После этого пластина отодвигается и процесс повторяется вплоть до того, пока машина полностью не заполнит ее рисунками слоя транзисторов для будущих микросхем.
Обработка одной пластины занимает у EUV-машины около 18 секунд. В течение этого времени шаблон переносится около сотни раз. Затем загружается следующая пластина и все повторяется. После завершения пластина загружается в другую разновидность фотолитографической машины где поверх слоя транзисторов формируется несколько слоев соединений. В некоторых случаях для печати соединений может использоваться более простой фотолитографический процесс (DUV). Толщина стороны каждого транзистора в слое составляет около 13 нм. Фотолитографическая машина копирует рисунок со слоем транзисторов менее чем за секунду.
Кремниевые подложки подаются сложенными в специальные контейнеры (FOUP), которые транспортируются от одной машины к другой с помощью автоматизированной подвесной системы. Контейнер опускается над необходимой машиной для обработки и последовательно выгружает пластины для нанесения на них необходимого рисунка с транзисторным слоем, или соединениями, засветки или удаления материала.
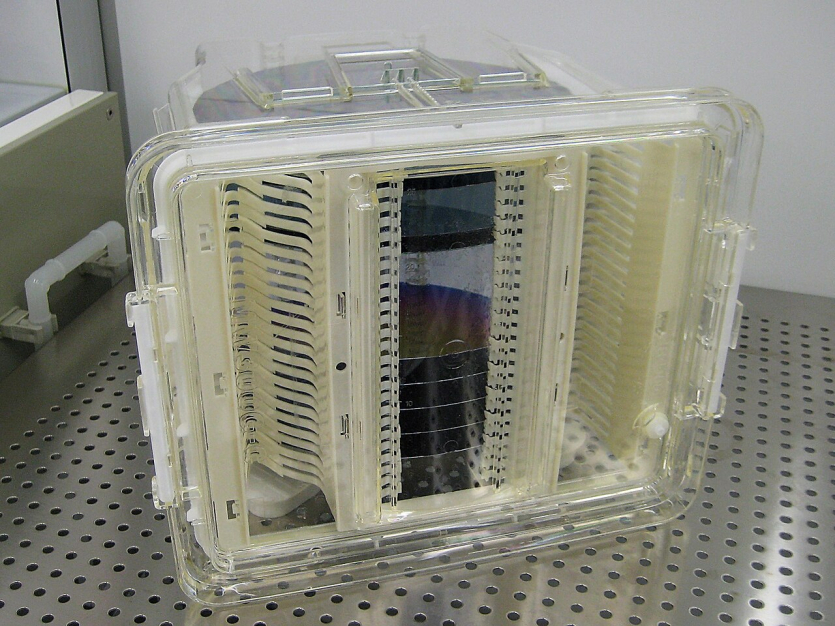
По завершении того или иного процесса пластины снова загружаются в (FOUP) и транспортируются к следующей машине, пока не будут нанесены все слои. Это можно сравнить с распылением краски на бумагу с помощью трафарета. Различные типы машин выполняют разные задачи. Одни осаждают материал на кремниевую пластину или наоборот удаляют уже нанесенный. Машины EUV и DUV работают как трафареты, переносящие контуры необходимого рисунка на пластину перед непосредственным осаждением материала.
Нанесение слоев микросхем на кремниевую подложку
Слои микросхем на кремниевых пластинах создаются отдельной установкой, называемой трековым инструментом. Она добавляет на подложку светочувствительный материал — фоторезист, который равномерно распределяется по поверхности пластины за счет вращения в центрифуге. Для затвердевания фоторезиста пластину нагревают и высушивают. После этого кремниевую пластину транспортируют к EUV-установке. На ней ультрафиолетовый свет, проходящий через фотомаску, уменьшается зеркалами и направляется на малый участок пластины.
Под воздействием ультрафиолета фоторезист оставляет отпечаток рисунка схемы на поверхности пластины. Затем пластина отодвигается и процесс повторяется до сотни раз, пока вся пластина не заполнится этими рисунками. Затем пластина снова транспортируется к трековой установке, где фоторезист смывается с ее поверхности с помощью растворителя. Для затвердевания оставшегося фоторезиста пластину снова нагревают и высушивают.
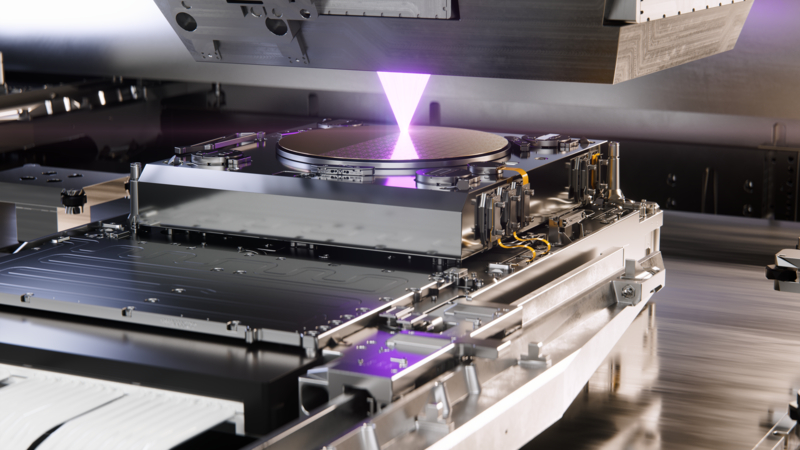
Далее пластину транспортируют к другим машинам, где производится травление участков без фоторезиста. Различные химические вещества распыляются на эти участки. Часть из них заполняет образованные канавки, а другие формируют основу для следующего слоя. Этот процесс многократно повторяется, пока поверх первого слоя не образуется много дополнительных слоев соединений. Через них транзисторы должны обмениваться между собой сигналами. Снизу с транзисторами контактируют самые тонкие соединения, а сверху размещаются самые большие.
Эти циклы повторяются десятки раз, включая около тысячи отдельных этапов. Именно поэтому для создания одной пластины с микросхемами необходимо около 4 месяцев. Слой транзисторов формируется машинами EUV с экстремально короткими волнами ультрафиолетового света длиной около 13 нм. Верхние соединения в основном формируются машинами DUV с ультрафиолетовыми волнами длиной от 193 до 365 нм. Производство с помощью DUV-машин дешевле, чем с помощью передовых EUV. Более простые микросхемы без необходимости наличия сложных техпроцессов выполняются преимущественно с помощью них.
Из чего состоит и как работает EUV-машина
EUV-машина состоит из источника света, осветителя, манипулятора и столика визирной сетки, проекционной оптики и манипулятора и столика для пластин. Ключевым элементом выступает источник экстремального ультрафиолетового света. На длине волны 13 нм он позволяет копировать рисунки с линиями толщиной 10 нм. Использование света с большей длиной волны не позволит ему попасть в крошечные отверстия на фотомаске и узор рисунка будет потерян.
Зато экстремально короткие ультрафиолетовые волны прекрасно проходят через фотомаску и четко переносят на пластину все детали и контуры. Ультрафиолетовое излучение с такой длиной волны не возникает естественным путем, его можно создать только искусственно с помощью двух лазеров и нескольких усилителей, установленных под EUV-машиной.
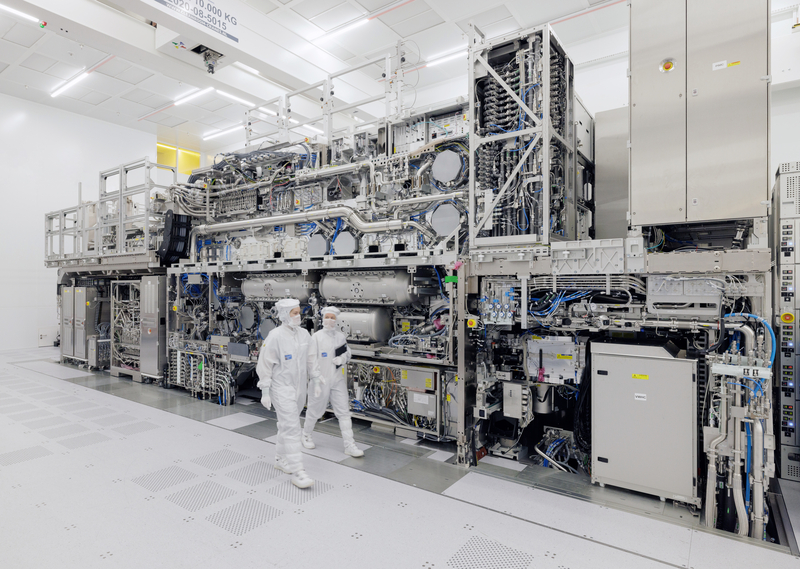
Зеркала направляют лазерные импульсы в контейнер-источник, где на их пути распыляются микроскопические оловянные шарики. Первый импульс мощностью 5 кВт превращает олово в жидкую каплю. При взаимодействии со вторым импульсом мощностью 25 кВт эта капля испаряется и переходит в состояние раскаленной плазмы. В результате этого процесса происходит высвобождение электронов, создавая необходимый EUV-свет. Олово для этого хранится в специальной емкости, где поддерживается в в расплавленном состоянии. Система шлангов подает его в пьезоэлектрический распылитель, который за счет высокого давления азота внутри собственного резервуара обеспечивает подачу тонкой и равномерной струи.
Траекторию капли олова при попадании в рабочую область контейнера отслеживают несколько высокоскоростных камер. Информация передается приводам зеркал, которые сдвигают отраженный лазерный луч так, чтобы он попал точно в каплю. Для того чтобы образовать EUV-свет необходимой интенсивности, лазерные импульсы бьют по каплям около 50 тыс. раз в секунду. Для поддержания равномерного излучения система пропускает некоторые капли мимо лазера и они попадают в специальный канал отвода.
Излучаемый свет собирается в пучок с помощью зеркала-коллектора. Он направляется в промежуточный фокус — микроскопическое отверстие, пропускающее только EUV-лучи, отсеивая остальные с большими длинами волн. Луч ультрафиолетового света попадает в осветитель, который состоит из нескольких фацетных зеркал, рассеивающих его на более широкий пучок. Он направляется на фотомаску. Лучи, которые проходят сквозь нее, с помощью ряда отдельных зеркал направляются уже на поверхность кремниевой пластины.
EUV-свет и его особенности
Поскольку EUV-свет в отличие от видимого света сразу же поглощается молекулами кислорода, на его пути внутри EUV-машины всегда поддерживается вакуум. Более того, экстремальный ультрафиолетовый свет также поглощается стеклом и почти всеми материалами. Поэтому для фокусировки и передачи этого света используются зеркала, а не линзы. Однако обычные зеркала также не подойдут для такой задачи. В EUV-машинах используются зеркала, называемые отражателями Брэгга. Они состоят из десятков чередующихся между собой слоев кремния и молибдена толщиной всего в несколько нм.
Во время попадания EUV-луча на поверхность этого отражателя, только 3% света отражается от одного слоя, а остальные проходят сквозь него. Луч отражается от каждого из большого количества слоев и в целом позволяет одному отражателю перенаправить более 70% света, который на него попадает. Оптическая система EUV-машины насчитывает более 10 зеркал. Таким образом, часть исходного потока света теряется после каждого отражения. В итоге до кремниевой пластины доходит лишь около 10% от его первоначальной яркости. Именно поэтому начальный свет от источника должен быть очень ярким.
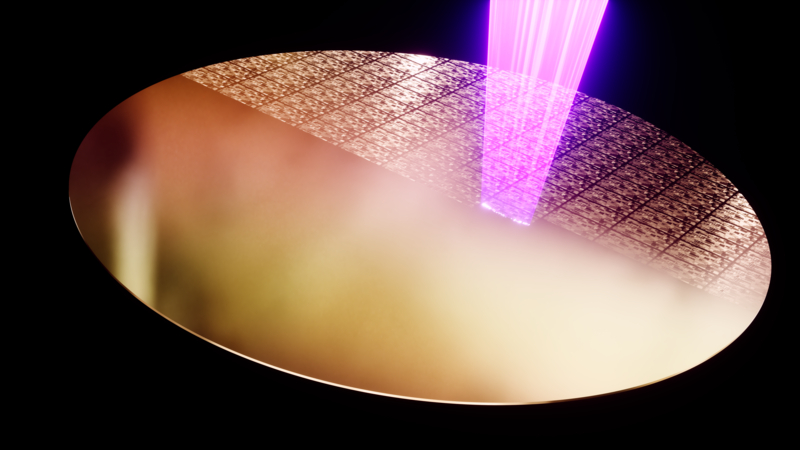
Фацетные зеркала в EUV-установки состоят из большого количества сегментов. Наклон каждого из этих сегментов управляется независимо с помощью системы с крошечным электроприводом. Это позволяет создавать из точечного EUV-света сложные рисунки. Тип рисунка зависит от конкретной фотомаски. Для преимущественно горизонтальных соединений подходит одна схема освещения, вертикальных — другая, а для круглых межслойных соединений — третья. Для точечных межслойных соединений свет должен быть направлен вниз, а для создания прямых непрерывных линий он должен быть направлен под углом.
Как работает фотомаска
Фотомаска с помощью подвесной транспортировочной системы под вакуумом загружается в EUV-установку. После этого сверяется ее штрих-код и проводится проверка на отсутствие дефектов. Положение маски выравнивается по специальным меткам с краев с точностью до 1 нм. Маска закрепляется на столике визирной сетки. Во время работы установки столик движется вдоль лучей EUV-света с очень высокой скоростью и последовательно проецирует каждую линию рисунка с маски на кремниевую подложку.
Поверхность маски похожа на вышеупомянутый отражатель Брега, однако там, где рисунок отсутствует, используется светопоглощающий материал. Точечные размеры этого материала составляют примерно 10×10 нм. Размеры самой маски составляют около 104×132 мм. Это позволяет получать рисунок в очень высоком разрешении.
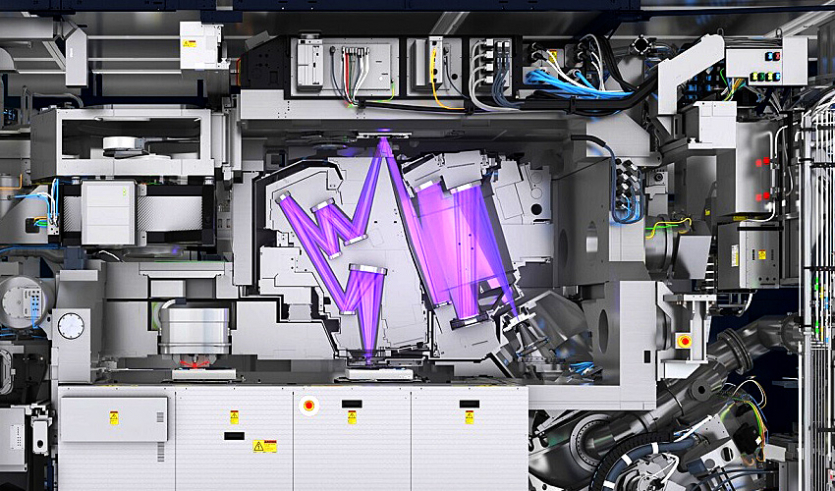
Зеркала масштабируют рисунок с маски и проецируют на пластину в уменьшенном виде. Каждая маска может содержать один или несколько шаблонов будущих микросхем в зависимости от их размера. Она способна вмещать один большой шаблон GPU два меньших шаблона CPU, или 12 микросхем ОЗУ. В зависимости от размеров микросхем меняется и их общее количество для размещения на одной пластине. Таким образом на одной подложке можно разместить около 90 больших GPU, около 185 CPU, или до тысячи чипов памяти.
На фотомаске не должно быть ни одного дефекта, чтобы не повредить шаблоны будущих чипов на пластине.
Обработка кремниевых пластин и фоторезист
Пластины в контейнерах FOUP доставляются на литографический кластер, который состоит из трековой установки и EUV-машины. Под вакуумом пластина перемещается из FOUP в трековую установку. В первой области производится нанесение фоторезиста, после перемещения во вторую область пластина нагревается и высушивается. С помощью роботизированного манипулятора пластина через вакуумный шлюз переносится в EUV-установку. Эта система под названием TwinScan способна одновременно переносить две пластины. Пока проходит обработка одной, другую в это время можно загрузить на столик и выровнять с точностью до нм.
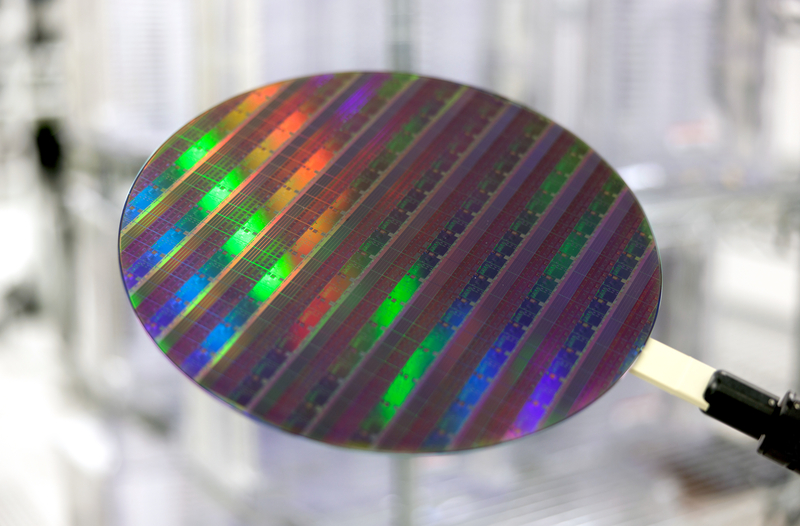
Для проверки идеальной совместимости формируемого слоя с предыдущим, пластину тщательно проверяют с помощью меток совместимости и датчиков выравнивания. Эта информация используется для создания высокоточной двумерной карты смещений. Датчики выравнивания также используют отраженный свет для измерения высоты по всей поверхности пластины, формируя таким образом топологическую карту пластины, что позволяет идеально фокусировать EUV-лучи на ее поверхность. По мере готовности микросхем пластину разрезают в соответствии с их размерами. Именно поэтому между рисунками на пластине должны оставаться небольшие промежутки. После нанесения одной копии рисунка затвор столика визирной сетки временно перекрывается, пока столик вместе с пластиной не сдвинется и не займет положение для печати следующего шаблона.
Фоторезист — это смесь синтетической смолы с фоточувствительным органическим красителем — сенсибилизатором. Во время попадания фотонов EUV-света на смолу, высвобождаются электроны с высокой энергией. Под их воздействием сенсибилизатор превращается в кислоту, которая ослабляет структуру смолы.
Таким образом на участках, на которые воздействовало EUV-излучение, фоторезист легко удаляется с помощью проявляющей жидкости. При этом резист не разрушается на отдельные куски, а ослабевает только на тех участках, куда проникло EUV-излучение. Это позволяет создавать четкие контуры элементов транзисторов и их соединений.
Чего ждать на рынке EUV-литографии в ближайшее время
Интересно, что пока нидерландская компания сохраняет за собой монополию на производство EUV литографических установок. Однако китайские специалисты, которые неоднократно пытались узнать секреты машины ASML, на фоне жестких ограничений на поставки этого оборудования со стороны США и Нидерландов, наконец заявляют о собственной разработке. В частности, Huawei несколько лет назад заявила о патентовании фотолитографической машины для изготовления микросхем CPU размерами около 10 нм. Однако большинство аналитиков восприняло это заявление скептически. Сейчас китайские производители чипов все еще критически зависят от ASML в поставках этого оборудования, даже получая более старые машины, которые на 8 итераций отстают от флагманской продукции нидерландской компании.








Сообщить об опечатке
Текст, который будет отправлен нашим редакторам: