
Intel спільно з SoftBank завершує розробку нового стандарту пам’яті Z-Angle Memory (ZAM), кидаючи виклик HBM.
Зазначається, що ZAM запропонує вдвічі більшу пропускну здатність за HBM4, наближаючись до стандарту HBM4E, який має з’явитись десь наступного року. Однак очікується, що розробка ZAM завершиться не раніше 2028-2030 років. Тож до серійного виробництва ще далеко.
У рамках конференції VLSI Symposium 2026 Intel та SoftBank представлять нові подробиці. Однак навіть вже оприлюднені дані проливають значно більше світла на цей проєкт. Відомо, що ZAM отримає 9-шарову структуру. Окремий стек включатиме 8 модулів DRAM з кремнієвою підкладкою завтовшки 3 мкм між кожним. Основна підкладка включатиме один логічний контролер, який доповнюватиме всі 9 модулів пам’яті.
Кожен з трьох ключових рівнів TSV міститиме 13,7 тис. міжз’єднань через кремнієві перехідні отвори, які використовують гібридне з’єднання. Кожен рівень забезпечує 1,125 ГБ, отже виходить 10 ГБ на стек, або 30 ГБ у всьому корпусі. Розміри стека складають 171 мм², а пропускна здатність — 0,25 Тб/с на мм², що дорівнює 5,3 ТБ/с на кожен стек.
Серед основних переваг — ширша щільність смуги пропускання ~0,25 Тб/с/мм², дещо вища ніж в HBM. Низьке енергоспоживання завдяки оптимізації. Чудове розсіювання тепла, оскільки вертикальна архітектура забезпечує краще керування тепловим режимом у той час, як HBM зазнає перегріву через шари провідників.
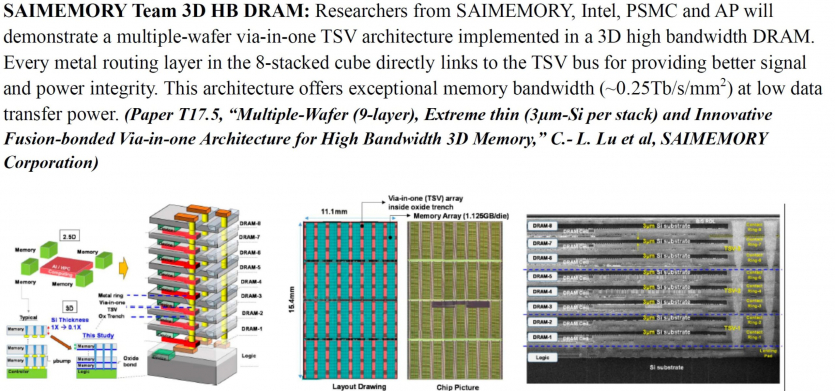

ZAM має надвисоку щільність шарів, підтримуючи понад 9 шарів з надзвичайно тонкими кремнієвими елементами та наскрізними міжз’єднаннями TSV в кожному шарі. Новий стандарт пам’яті також пропонує бездротове введення/виведення з магнітним полем та вдосконалену технологію об’єднання каналів для масштабованості. Архітектура ZAM оптимізована під ШІ, усуваючи обмеження HBM для робочих навантажень генеративного ШІ.
Кінцевою метою є створення щільної 3D-конструкції з використанням технології 3.5D-пакування, яка розміщує вертикальні та горизонтальні шари, включно з високошвидкісним великим стеком пам’яті, лінією живлення/заземлення, кремнієвою фотонікою та застарілими інтерфейсами введення/виведення на одній підкладці.
Раніше ми писали, що ASRock запропонувала нову модифікацію пам’яті HUDIMM для бюджетних ПК. Samsung готує нову пам’ять QLC NAND.
Забудьте про гігагерци при купівлі RAM: ось що насправді визначає швидкість пам’яті
Джерело: Wccftech










Повідомити про помилку
Текст, який буде надіслано нашим редакторам: